这款
半导体经晶圆热处理系统是为半导体晶圆在可控气体、真空、氧化或还原气氛中的晶圆高温处理系统,可对晶圆真空退火,氧气退火处理。
铝室的特殊设计允许在极高温度(高达1300°С)下进行热退火,并结合长时间退火(高达60分钟)。
该
半导体经晶圆热处理系统既可用于研发活动,也可用于中试生产。加工后的晶圆***大直径为150mm。
半导体经晶圆热处理系统的*点之一是加热器和反应器加热晶片分离。加热器由位于反应器外部的卤素灯组成,通过工艺室中的石英窗口加热石墨工作台。这种加热器允许进行***高温度高达1300°С、加热速率高达150°С/秒的工艺。水冷铝室允许进行长期退火。反应器可在工艺气体排气后进行初步泵送。
![$title $title]() 半导体经晶圆热处理系统特色
半导体经晶圆热处理系统特色
•带水冷的铝制工艺室
•带空气冷却的卤素灯加热装置
•通过膜或可选涡旋泵对工艺室进行初步泵送
•泵送和气体吹扫的自动化,允许通过«一键按下»执行过程
•内置PID控制器的多级过程
•光学高温计,用于额外的温度控制(可选),光学进入150 mm晶圆的中心和边缘
•工作台温度由两个热电偶控制
•易于操作和维护
半导体经晶圆热处理系统可订购型号
•真空热退火
•在受控气体环境中进行热退火,并用惰性气体持续吹扫试验箱
•在自动保压的受控气体气氛中进行热退火
半导体经晶圆热处理系统规格参数
工艺过程反应器中的极限压力: <10Torr (可选<5×10
-7)
泵浦速率: 5 m^3/h
反应器壁水冷: 是的
***大晶圆直径:150mm
***大加热速率:200℃/s (不带电极夹具)
***大加热速率:50℃/s (带电极夹具)
***大加热温度:1300℃
热均匀性@100mm直径: +/-1(<500摄氏度), +/-2(<1300℃)
真空退火:标配
氧气退火: 标配
自动化退货:标配
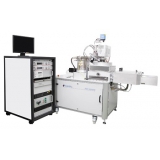
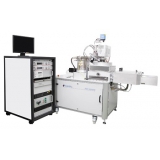
 晶圆热退火炉
晶圆热退火炉
 等离子体增强化学气相沉积系统
等离子体增强化学气相沉积系统
 电感耦合等离子体化学气相沉积系统
电感耦合等离子体化学气相沉积系统
 电子束蒸发系统
电子束蒸发系统
 磁控溅射物理气相沉积
磁控溅射物理气相沉积
 高压PVD系统
高压PVD系统




